Na rozdíl od V-NAND zde ovšem není vícevrstvý samotný křemíkový čip a místo toho je v pouzdře složeno více jednotlivých čipů, které jsou navzájem propojeny. Navrstvení více čipů nad sebe ovšem kvůli potřebě vyvést ven kontakty není tak jednoduché, jak by se mohlo zdát, Samsung k tomu použil technologii TSV (through silicon vias, „cesty skrz křemík“). To znamená, že čipy jsou provrtány velkým množstvím děr (údajně v řádu stovek), v nichž jsou poté vytvořeny vodiče vedoucí ke kontaktům čipů nacházejících se ve vyšších patrech. TSV tak umožňují navýšit hustotu tranzistorů, nebo obecně dostat více čipů do jednoho prostoru – například pro integrování rychlé paměti k GPU nebo CPU.
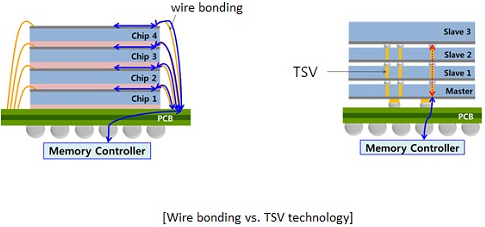
Vrstvené čipy propojené pomocí TSV slibují vysoké kapacity i úsporu energie
Paměti, které nyní Samsung začíná vyrábět, mají pomocí TSV spojeny zatím čtyři vrstvy čipů DDR4. Ty mají o sobě kapacitu 4 Gb (512 MB) a moduly DIMM, které takto vzniknou, pak nesou celkem 64 GB paměti v 36 pouzdrech a jsou typu registered. Určené jsou zejména pro servery s Xeony E5 na bázi generace Haswell-EP, které jsou již za rohem.
Do budoucna je ale otevřena cesta k ještě vyšším kapacitám, neboť počet vrstev umístěných nad sebou a propojených pomocí TSV je údajně možné ještě zvýšit. Navíc 4 Gb na čip dnes již nejsou maximem, takže kapacita by se mohla zdvojnásobit na 128 GB na modul DIMM, pokud Samsung přejde na 8Gb čipy. Přitom by ani modul nemusel přesáhnout standardní rozměry – a výhledově by TSV mohly být efektivní cestou k dosažení vysokých objemů paměti RAM v noteboocích a mobilních zařízeních.

64GB moduly DDR4 s vrstvenou 3D pamětí na bázi TSV od Samsungu
Samsung momentálně tuto paměť vyrábí procesem „třídy 20 nm“, což znamená něco mezi 20 a 29 nm. Efektivní takt je 2133 MHz, což není ve srovnání s DDR3 mnoho, nicméně u těchto modulů se hraje spíše na kapacitu a serverové čipy obvykle vysoké takty RAM nepoužívají.
Samsung mimochodem uvádí, že technologie TSV by měla znamenat i energetické úspory oproti modulům s vyšším počtem pouzder či jinak řešeným nahuštěním čipů. Spotřeba údajně může být i poloviční – alespoň dle tiskové zprávy. I tato vlastnost by byla užitečná v noteboocích, takže doufejme, že se paměti s 3D čipy časem rozšíří i mimo oblast serverů.












































